Articles
- Page Path
- HOME > J Korean Powder Metall Inst > Volume 28(1); 2021 > Article
-
Article
착화제 첨가에 따른 웨이퍼 세정 용액 특성 분석 및 금속 용해 거동 - 김명석, 류근혁, 이근재*
- Analysis of Wafer Cleaning Solution Characteristics and Metal Dissolution Behavior according to the Addition of Chelating Agent
- Myungsuk Kim, Keunhyuk Ryu, Kun-Jae Lee*
-
Journal of Korean Powder Metallurgy Institute 2021;28(1):25-30.
DOI: https://doi.org/10.4150/KPMI.2021.28.1.25
Published online: January 31, 2021
단국대학교 에너지공학과
Department of Energy Engineering, Dankook University, Cheonan-si 311-16, Republic of Korea
- *Corresponding Author: Kun-Jae Lee, TEL: +82-41-550-3684, FAX: +82-41-559-7945, E-mail: kjlee@dankook.ac.kr
- - 김명석 · 류근혁: 학생, 이근재: 교수
• Received: February 5, 2021 • Revised: February 18, 2021 • Accepted: February 23, 2021
© The Korean Powder Metallurgy Institute. All rights reserved.
- 1,208 Views
- 19 Download
Abstract
- The surface of silicon dummy wafers is contaminated with metallic impurities owing to the reaction with and adhesion of chemicals during the oxidation process. These metallic impurities negatively affect the device performance, reliability, and yield. To solve this problem, a wafer-cleaning process that removes metallic impurities is essential. RCA (Radio Corporation of America) cleaning is commonly used, but there are problems such as increased surface roughness and formation of metal hydroxides. Herein, we attempt to use a chelating agent (EDTA) to reduce the surface roughness, improve the stability of cleaning solutions, and prevent the re-adsorption of impurities. The bonding between the cleaning solution and metal powder is analyzed by referring to the Pourbaix diagram. The changes in the ionic conductivity, H2O2 decomposition behavior, and degree of dissolution are checked with a conductivity meter, and the changes in the absorbance and particle size before and after the reaction are confirmed by ultraviolet-visible spectroscopy (UV-vis) and dynamic light scattering (DLS) analyses. Thus, the addition of a chelating agent prevents the decomposition of H2O2 and improves the life of the silicon wafer cleaning solution, allowing it to react smoothly with metallic impurities.
- 반도체 디바이스의 제조공정에서 공정 모니터링용으로 사용되는 실리콘 웨이퍼는 일반적으로 막질 형성 및 오염 으로 인하여 재사용이 불가능하다[1]. 하지만 폐웨이퍼를 특수한 공정을 통하여 재가공하면 더미 웨이퍼(Dummy Wafer)로 사용이 가능하다[1]. 이러한 더미 웨이퍼는 프라 임 등급의 웨이퍼보다 낮은 규격의 재생 웨이퍼로, 반도체 산화막 공정 단계에서 성능과 조건을 확인하는데 사용된 다[2]. 재생 웨이퍼 제작 공정이 진행되는 과정에서 폐웨 이퍼 표면의 많은 잔류물은 소자의 성능, 신뢰성 및 수율 등에 부정적인 영향을 미친다[3, 4]. 잔류물 중 금속 불순 물은 PN 접합의 누설전류를 증가시키고 게이트 산화막의 항복 전압을 감소시키며, 에칭, 포토에칭, 증착 등과 같은 공정에 부정적인 영향을 끼치는 것으로 알려져 있다[4, 5]. 따라서 이러한 문제점을 해결하기 위하여 금속 불순물을 제거하는 웨이퍼 세정 과정이 필수적이다.
- 실리콘 웨이퍼 표면의 불순물을 제거하는 공정은 크게 습식 세정 공정과 건식 세정 공정으로 나눌 수 있다[6]. 습 식 세정 공정에는 RCA cleaning(Radio Corporation of America), SPM(Sulfuric Peroxide Mixture) 및 DHF(Dilute Hydrofluoric Acid)를 사용하는 세정 등이 있으며, 건식 세 정 공정은 플라즈마, 레이저, 에어로졸 및 오존을 사용하 는 세정 등이 있다[7, 8]. 하지만 건식 세정 공정은 웨이퍼 의 구조물이 파괴될 수 있다는 단점이 있고, 건식 세정 공 정만 단독으로 사용할 경우 완벽한 세정이 되지 않아 기 존의 습식 세정 공정과 병행해야 하는 문제점이 있기 때 문에 습식 세정이 일반적으로 사용된다[8]. 가장 대표적인 습식 공정인 RCA cleaning은 고농도의 강산 및 강염기의 화학약품을 사용하는 고온 습식 공정으로, 보통 SC- 1(Standard Clean - 1)과 SC-2(Standard Clean - 2)의 두 단 계로 구성된다[9-11]. SC-1은 NH4OH, H2O2 및 D.I water 의 혼합액을 사용하여 상대적으로 고온인 75-85°C에서 진 행되는 세정 공정으로, 웨이퍼 표면의 미세입자를 제거하 는 데 적합하다. 하지만 H2O2의 에칭 반응으로 인하여 웨 이퍼 표면 거칠기가 향상되고, 높은 pH 조건하에 metal hydroxides가 형성되는 문제점이 있다[12, 13]. 생성된 metal hydroxides 및 잔여 불순물은 강산 기반의 SC-2와 같은 추가적인 공정을 통하여 제거된다[14]. 그러나 SC-2 에 사용되는 강산으로 인하여 웨이퍼 표면 거칠기가 증가 되고 낮은 pH 조건에서 표면 전하가 없기 때문에 오염물 이 재흡착 되는 문제점이 발생한다[15]. 이와 같은 문제점 을 해결하기 위하여 Gale 등은 기존 RCA cleaning에 착화 제를 첨가함으로써 웨이퍼의 표면 거칠기 감소, 세정 용액 의 안정성 개선 및 불순물의 재흡착을 방지할 수 있는 세 정 기술을 제안하였다[16]. 하지만 착화제 첨가만으로 모 든 금속 불순물들을 제거하지 못하므로 HF 및 HCl 등을 사용하는 후속 세정 과정을 추가적으로 거쳐야 하는 문제 점이 있다[16].
- 따라서 본 연구에서는 불순물의 재흡착, 표면 거칠기 향상, 세정 용액의 수명 감소 및 추가적인 세정 공정과 같은 기존 SC-1 세정 용액의 문제점을 보완하기 위하여 금속과 반응하여 배위화합물을 형성하는 착화제인 EDTA (Ethylenediaminetetraacetic Acid)를 첨가하여 다양한 금속 과의 용해 거동을 확인하고자 하였다. 각 세정 용액의 시 간에 따른 이온전도도 변화를 통하여 세정 용액의 안정성 및 금속 용해 거동을 분석하고자 하였으며, 반응 전과 후 세정 용액의 흡광도와 입도 크기 변화를 비교하여 착화제 와 금속 간의 결합 안정도를 분석하고자 하였다.
1. 서 론
- 2.1. EDTA 첨가에 따른 금속 용해 거동
- 착화제에 따른 금속 용해 거동을 알아보기 위하여 기존 SC-1 세정 용액(H2O2(30%, DAEJUNG), NH4OH(25.0~ 28.0%, DAEJUNG), D.I water)에 착화제인 EDTA(98.5%, DAEJUNG)를 첨가하여 실험을 진행하였다. SC-1 세정 용 액은 H2O2, NH4OH 및 D.I water를 각각 1:1:5 vol%의 비 율로 상온에서 교반하여 용해시켰고, 혼합된 용액에 EDTA를 pourbaix diagram을 참고하여 16 g 장입하였다. 준비된 세정 용액 50mL에 웨이퍼 표면에 존재하는 금속 불순물인 Cr(99.0%, DAEJUNG), Ni(99%, DAEJUNG), Fe(≥99.0%, ALDRICH)을 각각 0.002 g씩 70 mL vial에 장 입한 후 초음파기에 반응시켜 진행하였다. 초음파기 냉각 수 온도는 25~30°C로 유지하여 진행하였으며, 총 12시간 반응시켜 3시간 간격으로 금속과 SC-1 세정 용액 간의 결 합 안정도를 분석하였다. 사용된 초음파 발생기 진동자의 진동수와 출력은 각각 132 kHz, 300W 였으며, 용기 규격 은 295 mm × 240 mm × 160 mm 이었다.
- 2.2. 특성 평가
- Conductivity meter(SevenExcellence™, Mettler-toledo)를 사용하여 세정 용액의 시간 별 이온전도도를 측정하여 금 속 분말의 용해 거동을 분석하였다. 또한, Ultravioletvisible spectroscopy(UV-1800, SHIMADZU)을 사용하여 반응 전과 후의 흡광도를 비교하였으며, DLS(Dynamic Light Scattering)을 통하여 반응 전과 후의 금속 분말의 입 도를 비교 분석하였다.
2. 실험 방법
- 그림 1은 금속 분말 Cr, Fe 및 Ni을 각각 기존 SC-1 세 정 용액과 반응시켜 시간에 따른 이온전도도 변화를 나타 낸 그래프이다. 그림 1(a)와 (c)는 Cr 및 Ni의 이온전도도 변화를 나타낸 그래프로 반응 3시간 후에 이온전도도의 변화는 각각 65.0%, 61.8%의 감소율을 나타내며, 3시간 이후 완만한 곡선을 나타내었다. 또한 그림 1(b)는 Fe의 이온전도도 변화를 나타낸 그래프로 반응 3시간 후에 이 온전도도의 변화율은 57.6%의 감소율을 나타내고, 6시간 이후 완만한 곡선을 나타내었다. 이는 금속 이온이 H2O2 분해 촉매로 작용하여 수산화 라디칼이 형성되기 때문에 세정 용액에서 이온전도도가 급격히 감소된 것으로 예상 된다[17]. 금속 M (Cr, Fe, Ni)과 H2O2 간의 반응식은 다 음과 같다[18].
- H2O2 분해 반응은 불순물 세정 반응이 진행되기 전에 급속하게 일어난다[19]. 따라서 용액 내 존재하는 H2O2의 농도가 급격히 감소하여 이로 인해 세정 용액의 수명이 감소되는 것으로 사료된다.
- 그림 2는 각 금속과 기존 SC-1 세정 용액의 반응 전과 후의 UV-vi s 분광법 결과와 입도 변화를 나타낸 그래프이 다. 금속과 기존 SC-1 세정 용액 간의 반응 전후 색상을 비교하는데 어려움이 있어, UV-vis 분광법을 이용하여 세 정 용액의 흡광도를 측정하였다. 그림 2(a) 와 (c)에서 알 수 있듯, Cr 및 Ni의 경우 세정 용액과의 반응 전후 흡광 도 피크는 서로 상이하게 나타내었다. 또한 그림 2(d) 와 (f)에서 보이듯, 입도 분석 결과 Cr의 평균 입도는 17.8 μm 에서 11.4 μm로 약 35.9% 감소하였으며, Ni의 평균 입도 는 29.2 μm에서 24.5 μm로 약 16.0%로 미세하게 감소하 였다. 이를 통하여 Cr 및 Ni의 경우 기존 SC-1 용액 내에 서 용해가 비교적 원활하게 이루어진 것으로 사료된다. 반 면에 Fe는 흡광도의 변화가 뚜렷이 나타나지 않고 평균 입도 변화 또한 12.1 μm에서 21.7 μm로 약 79.1% 증가하 였음을 확인하였다. 이는 Fe 이온과 OH기 간의 반응에 의 하여 침전물 Fe(OH)3가 형성되기 때문에, 기존 SC-1 세정 용액 내 Fe의 용해가 원활하게 이루어지지 않아 평균 입 도가 반응 후 평균 입도가 반응 전에 비하여 향상된 것으 로 예상된다[16]. Fe 이온과 OH기 간의 반응식은 다음과 같다[20].
- 그림 3은 착화제인 EDTA와 각 금속 원소 간의 반응에 대한 pourbaix diagram을 나타낸다. 세정 공정은 전압을 가하지 않고 수행되므로 pourbaix diagram의 전위를 0 V 로 고정하였다. 금속과 세정 용액 간의 반응은 pH가 높은 지점에서 빠르게 진행되는데, 이는 착화제의 동일한 활성 부위에 대한 금속과 hydronium 이온이 착화제와의 결합과 관련이 있다[21]. pH가 증가함에 따라 hydronium 이온이 감소하여 hydronium 이온과 착화제 사이의 반응이 감소하 고, 금속 이온과 착화제 사이의 반응이 증가하기 때문에 금속 이온의 결합이 더 원활히 이루어진다[21]. EDTA를 첨가함에 따라 세정 용액의 pH가 결정되는데, 이를 통하 여 pH가 높아 hydronium 이온을 형성하지 않고, EDTA와 SC-1에 반응하여 Cr, Fe, Ni이 각각 [CrIIIEDTA(OH)]2-, Fe(EDTA)(OH)2-, Ni(EDTA)2-와 같은 배위화합물을 형성 하는 조건인 pH 10에서 실험을 진행하였다. 금속, 세정 용 액 및 EDTA와의 반응식은 다음과 같다[22-24].
- 그림 4는 기존 SC-1 세정 용액에 EDTA를 첨가하여 pH 10으로 맞춘 세정 용액에 Cr, Fe 및 Ni을 각각 반응시켜 시간에 따른 이온전도도 변화를 나타낸 그래프이다. 그림 1과 비교하였을 때 반응 3시간 동안의 Cr, Fe 및 Ni의 이 온전도도 감소율은 각각 2.62%, 3.22%, 2.45%로, 그림 1 의 기존 SC-1 세정 용액 이온전도도 감소율에 비하여 현 저히 낮은 경향을 나타내었다. 이는 산화 분해에 내성이 있는 착화제인 EDTA가 H2O2의 급속한 분해를 방지하므 로 이온전도도 감소율이 기존에 비하여 줄어든 것으로 예 상된다[25]. 또한 초기 이온전도도의 감소 이후 금속과 EDTA 간에 배위화합물의 형성으로 인하여 이온전도도가 증가하는 현상을 보였다. 그림 4(a)와 (b)의 경우 각각 6시 간, 9시간 이후 이온전도도가 소폭 감소하는데, 이는 계속 되는 EDTA의 소모 및 H2O2 분해로 인한 현상으로 판단 된다. 이에 반해 그림 4(c)의 경우에는 반응 시작 12시간 이후에도 배위화합물이 안정적으로 형성되어 이온전도도 가 지속적으로 증가한 것으로 확인된다.
- 그림 5는 EDTA를 첨가한 SC-1 세정 용액 내에서의 금 속 분말 반응 전과 후 UV-visible 흡수 스펙트럼 및 입도 분포 변화를 나타낸다. 금속과 EDTA를 첨가한 SC-1 세정 용액 간의 반응 후 세정 용액의 색상은 무색에서 연한 노 란색으로 변화하였다. 그림 5(a) - (c)에서 보이는 바와 같 이, 기존 SC-1 세정 용액 내에서의 흡광도와 달리 모든 금 속 분말의 반응 전과 후 UV 흡수 스펙트럼은 서로 상이 한 경향을 확인하였다. 또한, 그림 5(d) - (f)와 같이 입도 분석 결과 Cr의 평균 입도는 17.8 μm에서 5.6 μm로 약 68.5% 감소하였고, Fe의 평균 입도는 12.1 μm에서 4.9 μm 로 약 59.6%, Ni의 평균 입도는 29.2 μm에서 18.3 μm로 약 37.2%의 감소율을 나타내었다. 이를 통하여 그림 2(d) - (f)와 비교하였을 때 기존 SC-1 세정 용액보다 EDTA가 첨 가된 세정 용액에서 반응한 금속 분말의 입도 감소율이 비교적 더 높은 경향을 나타내었음을 확인하였다. EDTA 와 분해 방지되어 잔류된 H2O2가 금속 입자와 반응하여 배위화합물을 형성하므로, 금속 입자의 크기는 기존 RCA cleaning의 SC-1 세정 용액에 비하여 EDTA가 첨가된 세 정 용액에서의 금속 용해가 비교적 원활하게 진행된 것으 로 예상된다. 그리고 기존 SC-1 세정 용액에서 반응한 Fe 의 평균 입도는 증가하는 경향을 나타내었고, EDTA가 첨 가된 세정 용액에서의 Fe의 평균 입도는 감소하였음을 확 인하였다. 따라서 Fe와 EDTA 간의 반응을 통하여 안정적 배위화합물을 형성하여 침전물이 발생하지 않고 원활한 용해가 이루어졌다고 예상된다.
3. 결과 및 고찰
Fig. 2

UV-visible absorption spectra (a) Cr, (b) Fe, (c) Ni and particle size distribution (d) Cr, (e) Fe, (f) Ni in SC-1 solution.

Fig. 4

Ionic conductivity change of (a) Cr, (b) Fe and (c) Ni with time in EDTA containing SC-1 solution.

- 본 연구에서는 금속 불순물의 재흡착, H2O2 분해 및 고 온 세정 등과 같은 기존 RCA c leani ng의 문제점을 해결하 기 위하여 착화제인 EDTA를 기존 SC-1 세정 용액에 첨 가하여 세정 용액과 금속 간의 결합 안정도를 분석하고자 하였다. 기존 세정 용액과 EDTA가 첨가된 세정 용액을 비교하기 위하여 웨이퍼 표면에 존재하는 금속 불순물인 Cr, Fe 및 Ni 분말을 각각 세정 용액에 장입한 후 총 12시 간 동안 반응을 진행하였으며, 반응 전과 후의 이온전도도, 흡광도, 입도 변화를 비교하였다. 시간별 이온전도도 분석 결과, 착화제를 첨가한 세정 용액이 3시간 반응 전과 후 Cr, Fe 및 Ni의 이온전도도 감소량이 3% 미만으로 나타나 기존 세정 용액에 비하여 현저히 낮아진 것을 확인할 수 있었다. 이는 산화 분해에 대한 내성이 강한 착화제인 EDTA가 첨가됨으로써 H2O2의 분해가 방지되어 반응 전 과 후의 이온전도도 감소율이 기존 세정 용액에 비하여 비교적 낮은 것으로 예상된다. UV 분석을 통하여 반응 전 과 후의 세정 용액의 흡수 스펙트럼은 서로 상이한 결과 가 나타남을 확인하였다. 또한, 기존 SC-1 세정 용액에서 의 금속 분말의 입도 변화는 미미하게 감소하거나 증가하 는 경향을 보였으나, EDTA를 첨가한 경우에는 모든 금속 의 입도가 현저히 감소함을 확인하였으며, 이를 통하여 착 화제가 첨가된 세정 용액과 금속 간의 결합이 원활하게 이루어졌다고 사료된다. 따라서 본 연구에서는 착화제를 통하여 기존 웨이퍼 세정 공정의 문제점을 해결할 수 있 었으며, 이를 통하여 웨이퍼 세정력을 향상시킬 수 있을 것으로 예상된다.
4. 결 론
-
Acknowledgements
- 본 연구는 중소기업청(MSS)에서 지원한 중소기업 기술 정보 진흥원(TIPA)의 지원을 받아 수행한 연구과제 (S2825750)이며, 이에 감사드립니다.
감사의 글
- 1. T. Uchida, K. Iijima, T. Yamazaki, S. Tomaru and F. Maruyama, Japan, JP 7005177 (2006). .
- 2. J. H. Bae, H. S. Lee, J. H. Park, H. Nishizawa, M. Kinoshita and H. D. Jeong: J. Kor. Inst. Electr. Electron. Mater. Eng., 23 (2010) 358. .Article
- 3. J. W. Kim and K. H. Park, Korea, KR 0049709 (2016). .
- 4. B. K. Choi and H. T. Jeon: Korean J. Met. Mater., 8 (1998) 837. .
- 5. S. W. Lee and C. M. Lee: Appl. Sci. Converg. Technol., 10 (2001) 267. .
- 6. J. M. Lee and S. H. Cho: KSLP, 4 (2001) 22. .
- 7. T. Hattori: Ultraclean surface processing of silicon wafers: secrets of VLSI manufacturing, T. Hattori (Ed.), Springer Science & Business Media, Berlin (2013) 61. .
- 8. S. R. Noh and S. S. You: KSDET., 16 (2017) 41. .
- 9. T. M. Pan, T. F. Lei, T. S. Chao, M. C. Liaw, F. H. Ko and C. P. Lu: J. Electrochem. Soc., 148 (2001) 315. .Article
- 10. A. Abbadie, J. M. Hartmann, P. Besson, D. Rouchon, E. Martinez, P. Holliger, C. D. Nardo, Y. Campidelli and T. Billon: Appl. Surf. Sci., 254 (2008) 6793. .Article
- 11. W. Kern: J. Electrochem. Soc., 137 (1990) 1887. .Article
- 12. J. Ryuta, E. Morita, T. Tanaka and Y. Shimanuki: Jpn. J. Appl. Phys., 29 (1990) 1947. .Article
- 13. H. Kobayashi, J. Ryuta, T. Shingyouji and Y. Shimanuki: Jpn. J. Appl. Phys., 32 (1993) 45. .Article
- 14. C. R. Inomata, H. Ogawa, K. Ishikawa and S. Fujimura: J. Electrochem. Soc., 143 (1996) 2995. .Article
- 15. G. H. Lee and S. I. Bae: Korean Chem. Eng. Res., 2 (2007) 203. .
- 16. G. W. Gale, D. L. Rath, E. I. Cooper, S. Estes, H. F. Okorn, J. Brigante, R. Jagannathan, G. Settembre and E. Adams: J. Electrochem. Soc., 148 (2001) 513. .Article
- 17. Y. S. Mok, J. O. Jo, S. T. Kim, W. T. Jeong, D. W. Kang, B. H. Rhee and J. K. Kim: KSEE, 29 (2007) 68. .
- 18. N. Kitajima, S. Funkuzumi and Y. Ono: J. Phys. Chem., 82 (1978) 1505. .Article
- 19. J. H. Kim, S. H. Kong, G. I. Son and Y. S. Kim: EER., 22 (2001) 73. .
- 20. Y. Mori, K. Uemura, K. Shimanoe and T. Sakon: J. Electrochem. Soc., 142 (1995) 3104. .Article
- 21. D. Liu, Z. Li, Z. X. Li and R. Kumar: Carbohydr. Polym., 111 (2014) 469. .ArticlePubMed
- 22. P. Ciesla, A. Karocki and Z. Stasicka: J. Photochem. Photobiol. A Chem., 162 (2004) 537. .Article
- 23. D. B. Kent, J. A. Davis, L. C. Anderson, B. A. Rea and J. A. Coston: Geochim. Cosmochim. Acta., 66 (2002) 3017. .Article
- 24. Y. G. Park and Y. S. Yang: Clean Technol., 20 (2014) 367. .Article
- 25. G. V. Korshin, H. S. Chang, A. I. Frenkel and J. F. Ferguson: Environ. Sci. Technol., 41 (2007) 2560. .ArticlePubMed
Figure & Data
References
Citations
Citations to this article as recorded by 

Analysis of Wafer Cleaning Solution Characteristics and Metal Dissolution Behavior according to the Addition of Chelating Agent



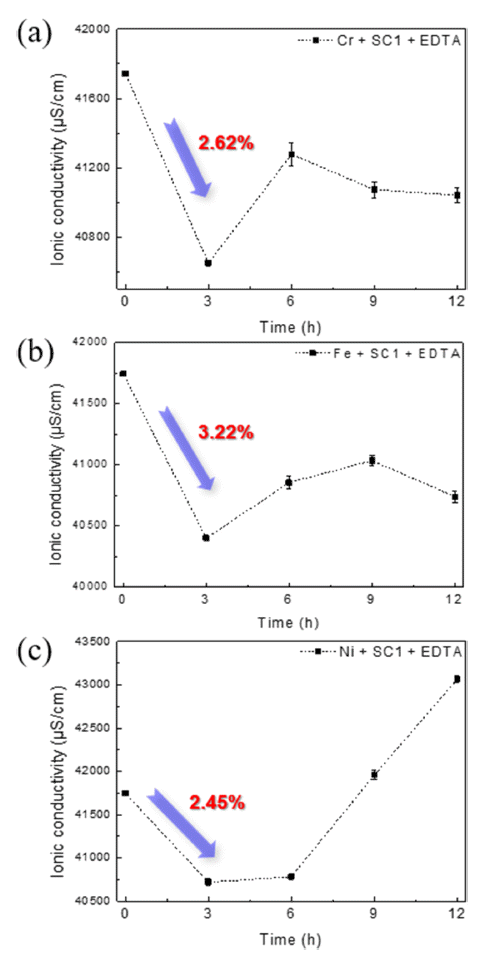

Fig. 1
Ionic conductivity change of (a) Cr, (b) Fe and (c) Ni with time in SC-1 solution.
Fig. 2
UV-visible absorption spectra (a) Cr, (b) Fe, (c) Ni and particle size distribution (d) Cr, (e) Fe, (f) Ni in SC-1 solution.
Fig. 3
Pourbaix diagram of metal in EDTA containing SC-1 solution at 0 V (a) Cr, (b) Fe and (c) Ni.
Fig. 4
Ionic conductivity change of (a) Cr, (b) Fe and (c) Ni with time in EDTA containing SC-1 solution.
Fig. 5
UV-visible absorption spectra (a) Cr, (b) Fe, (c) Ni and particle size distribution (d) Cr, (e) Fe, (f) Ni in EDTA containing SC-1 solution.
Fig. 1
Fig. 2
Fig. 3
Fig. 4
Fig. 5
Analysis of Wafer Cleaning Solution Characteristics and Metal Dissolution Behavior according to the Addition of Chelating Agent
TOP
 KPMI
KPMI

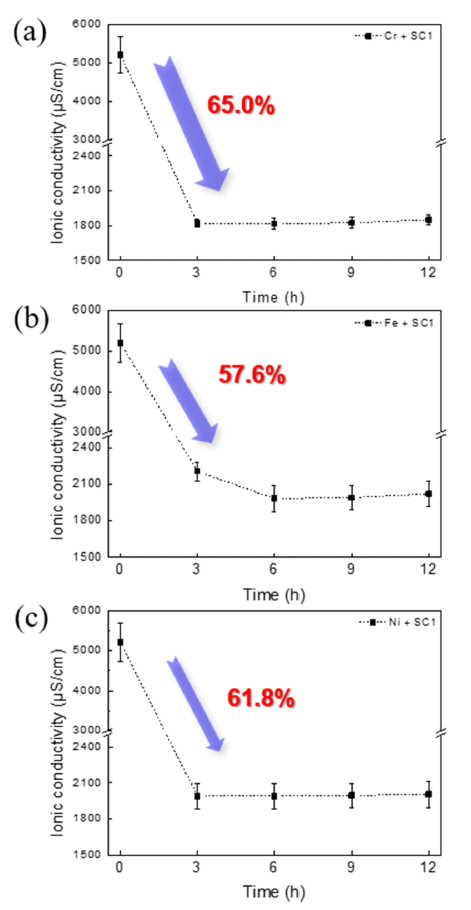
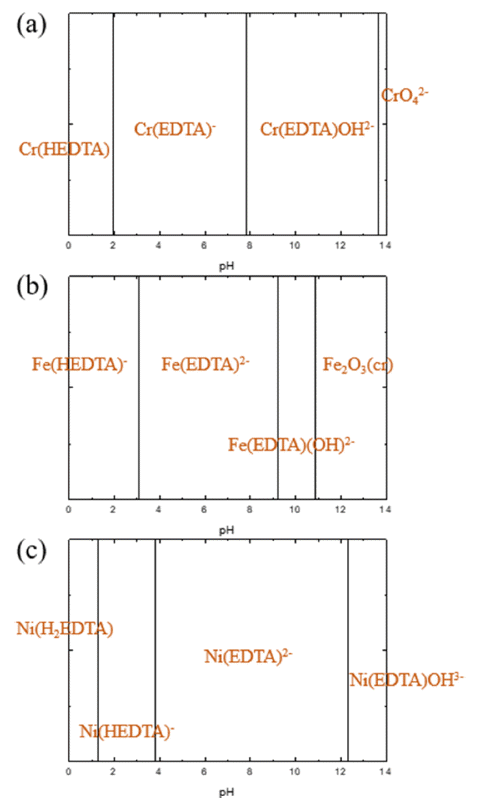
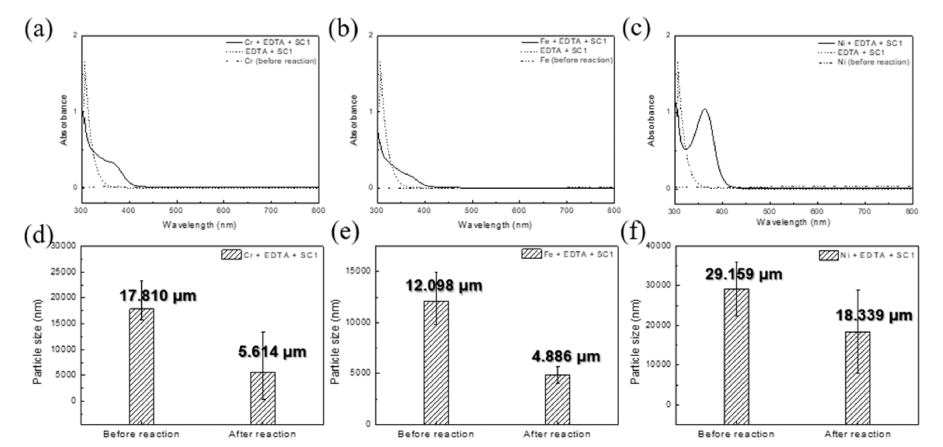
 ePub Link
ePub Link Cite this Article
Cite this Article